 离子注入和快速退火工艺电子教案Word格式.docx
离子注入和快速退火工艺电子教案Word格式.docx
- 文档编号:19555103
- 上传时间:2023-01-07
- 格式:DOCX
- 页数:18
- 大小:1.26MB
离子注入和快速退火工艺电子教案Word格式.docx
《离子注入和快速退火工艺电子教案Word格式.docx》由会员分享,可在线阅读,更多相关《离子注入和快速退火工艺电子教案Word格式.docx(18页珍藏版)》请在冰豆网上搜索。
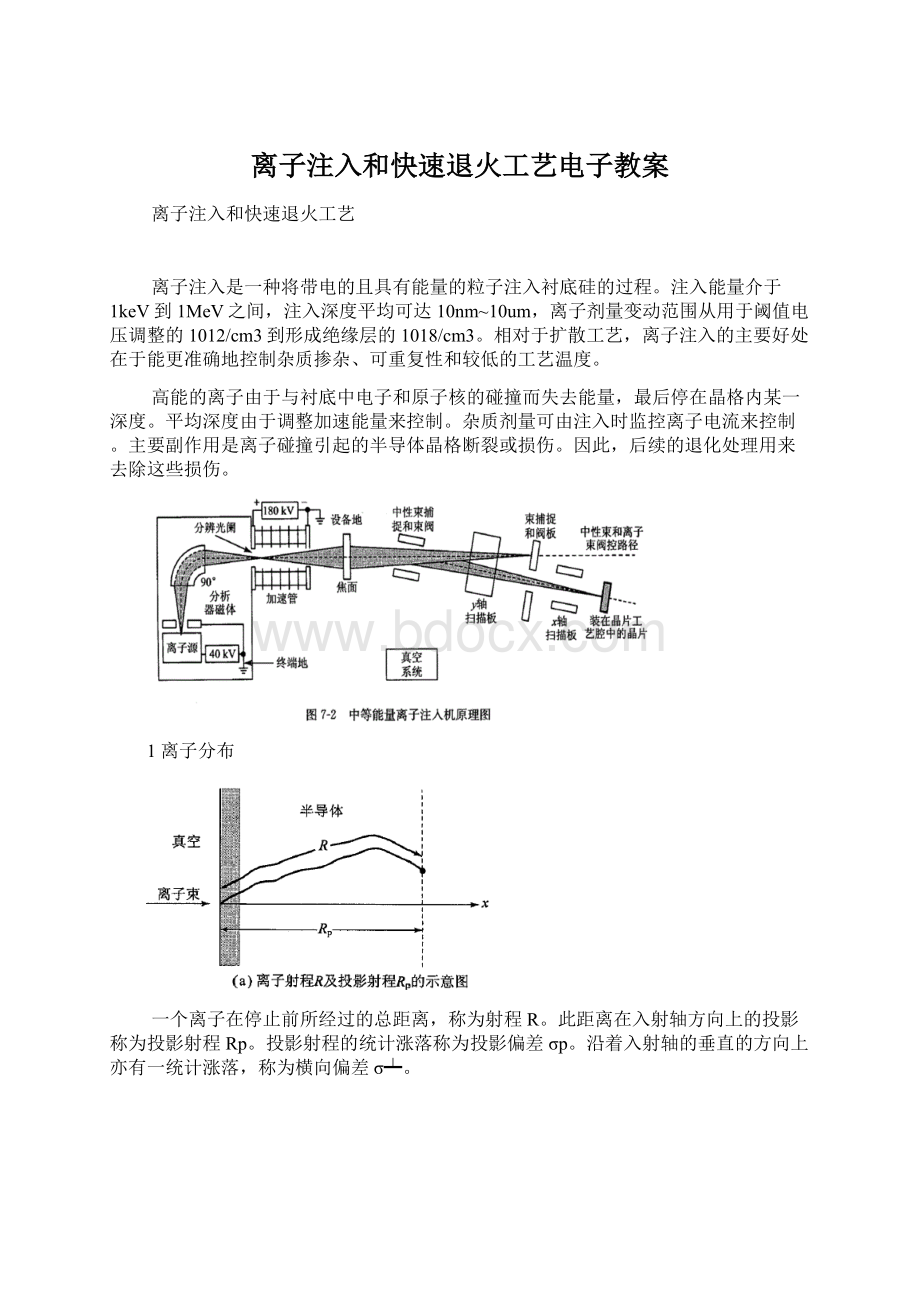
σp处,离子浓度比其峰值降低了40%。
在±
2σp处则将为10%。
3σp处为1%。
4σp处将为0.001%。
沿着垂直于入射轴的方向上,其分布亦为高斯分布,可用:
表示。
因为这种形式的分布也会参数某些横向注入。
2离子中止
使荷能离子进入半导体衬底后静止有两种机制。
一是离子能量传给衬底原子核,是入射离子偏转,也使原子核从格点移出。
设E是离子位于其运动路径上某点x处的能量,定义核原子中止能力:
二是入射离子与衬底原子的电子云相互作用,通过库仑作用,离子与电子碰撞失去能量,电子则被激发至高能级或脱离原子。
定义电子中止能力:
离子能量随距离的平均损耗可由上述两种阻止机制的叠加而得:
如果一个离子在停下来之前,所经过的总距离为R,则
E0为初始离子能量,R为射程。
核阻止过程可以看成是一个入射离子硬球与衬底核硬球之间的弹性碰撞M1转移给M2的能量为:
电子中止能力与入射离子的速度成正比:
其中系数ke是原子质量和原子序数的弱相关函数。
硅的ke值107(eV)1/2/cm。
砷化镓的ke值为3×
107(eV)1/2/cm
离子中止两种机制:
二是入射离子与衬底原子的电子云相互作用,通过库仑作用,离子与电子碰撞失去能量,电子则被激发至高能级或脱离原子。
硅中电子中止能力如虚线所示,交叉能量点是Sn(E)=Se(E)。
一旦Sn(E)和Se(E)已知,可计算处射程范围。
可以用下述近似方程式来求得投影射程与投影偏差:
3离子注入的沟道效应
前述高斯分布的投影射程及投影的标准偏差能很好地说明非晶硅或小晶粒多晶硅衬底的注入离子分布。
只要离子束方向偏离低指数晶向<
111>
,硅和砷化镓中的分布状态就如在非晶半导体中一样。
在此情况下,靠近峰值处的实际杂质分布,可用“高斯分布函数”来表示,即使延伸到低于峰值一至两个数量级处也一样,这表示在下图中。
然而即使只偏离<
晶向7度,仍会有一个随距离而成指数级exp(-x/λ)变化的尾区,其中λ的典型的数量级为0.1um。
衬底定位时有意偏离晶向情况下的杂质分布。
离子束从<
轴偏离7度入射。
指数型尾区与离子注入沟道效应有关,当入射离子对准一个主要的晶向
并被导向在各排列晶体原子之间时,沟道效应就会发生。
图为沿<
110>
方向观测金刚石晶格的示意图。
离子沿<
方向入射,因为它与靶原子较远,使它在和核碰撞时不会损伤大量能量。
对沟道离子来说,唯一的能量损伤机制是电子阻止,因此沟道离子的射程可以比在非晶硅靶中大得多。
4离子进入的角度及通道
<
100>
沟道效应降低的技巧
1、覆盖一层非晶体的表面层、将硅芯片转向或在硅芯片表面制造一个损伤的表层。
常用的覆盖层非晶体材料只是一层薄的氧化层[图(a)],此层可使离子束的方向随机化,使离子以不同角度进入硅芯片而不直接进入硅晶体沟道。
2、将硅芯片偏离主平面5-10度,也能有防止离子进入沟道的效果[图(b)]。
此方法大部分的注入机器将硅芯片倾斜7度并从平边扭转22度以防止沟道效应。
3、先注入大量硅或锗原子以破坏硅芯片表面,可在硅芯片表面产生一个随机层[图(c)],这种方法需使用昂贵的离子注入机。
5注入损伤与退火
离子注入中,与原子核碰撞后转移足够的能量给晶格,使基质原子离开晶格位置而造成注入损伤(晶格无序)。
这些离位的在也许获得入射能量的大部分,接着如骨牌效应导致邻近原子的相继移位而形成一个沿着离子路径的树枝状的无序区。
当单位体积内移位的原子数接近半导体的原子密度时,单晶材料便成为非晶材料。
轻离子的树枝状的无序区不同于重离子。
轻离子(11B+)大多数的能量损伤起因于电子碰撞,这并不导致晶格损伤。
离子的能量会减低至交叉点能量,而在那里核阻止会成为主导。
因此,晶格无序发生在离子最终的位置附近。
如下图(a)所示。
重离子的能量损失主要是原子核碰撞,因此预期有大量的损伤。
如下图(b)所示。
要估计将单晶转变为非晶材料所需的能量,可以利用一个判据,即认为注入量应该与融化材料所需的能量密度(1021keV/cm3)在数量级上相同。
对于100keV的砷离子来说,形成非晶硅所需的剂量为
6退火
由于离子注入所造成的损伤区及畸形团,使迁移率和寿命等半导体参数受到影响。
此外,大部分的离子在被注入时并不位于置换位置。
为激活被注入的离子并恢复迁移率与其它材料参数,必须在适当的时间与温度下将半导体退火。
传统退火炉使用类似热氧化的整批式开放炉管系统。
需要长时间和高温来消除注入损伤。
但会造成大量杂质扩散而无法符合浅结及窄杂质分布的需求。
快速热退火(RTA)是一种采用各种能源、退火时间范围很宽(100s到纳秒)的退火工艺。
RTA可以在最小的杂质再分布情况下完全激活杂质。
⏹退火:
将注入离子的硅片在一定温度和真空或氮、氩等高纯气体的保护下,经过适当时间的热处理,
⏹部分或全部消除硅片中的损伤,少数载流子的寿命及迁移率也会不同程度的得到恢复,
⏹电激活掺入的杂质
⏹分为普通热退火、硼的退火特性、磷的退火特性、扩散效应、快速退火
⏹普通热退火:
退火时间通常为15--30min,使用通常的扩散炉,在真空或氮、氩等气体的保护下对衬底作退火处理。
缺点:
清除缺陷不完全,注入杂质激活不高,退火温度高、时间长,导致杂质再分布。
7硼与磷的传统退火
退火的特性与掺杂种类及所含剂量有关
硼的退火特性
1区单调上升:
点缺陷、陷井缺陷消除、自由载流子增加
2区出现反退火特性:
代位硼减少,淀积在位错上
3区单调上升
剂量越大,所需退火温度越高。
磷的退火特性
杂质浓度达1015以上时出现无定形硅退火温度达到600℃~800℃
热退火问题:
⏹简单、价廉
⏹激活率不高
⏹产生二次缺陷,杆状位错。
位错环、层错、位错网加剧
扩散效应:
8快速热退火
一个具有瞬间光加热的快速热退火系统
表为传统炉管与RTA技术的比较。
为获得较短的工艺时间,需在温度和工艺的不均匀性、温度测量与控制、硅芯片的应力与产率间作取舍。
快速热退火
9注入相关工艺-多次注入及掩蔽
在许多应用中,除了简单的高斯分布外其它的杂质分布也是需要的。
例如硅内预先注入惰性离子,使表面变成非晶。
此方法使杂质分布能准确地控制,且近乎百分百的杂质在低温下激活。
在此情况下,深层的非晶体层是必须,为了得到这种区域,必须要做一系列不同能量与剂量的注入(多次注入)。
多次注入如下图所示,用于形成一平坦的杂质分布。
为了要在半导体衬底中预先选择的区域里形成p-n结,注入时需要一层合适的掩蔽层。
此层要阻止一定比例的入射离子其最小厚度可从离子的射程参数来求得。
在某一深度d之后的注入量对回忆式积分可得:
穿越深度d的剂量的百分比可由穿透系数T求得:
一旦得到了T,对任一恒定的Rp和σp来说,都可以求得掩蔽层厚度d,对SiO2、Si3N4与抗蚀剂来说,要阻挡99.99%的入射离子(T=10-4)所需的d值如下图所示。
图中内插图显示了在掩蔽材料内的注入物的分布。
10倾斜角度离子注入
当器件缩小到亚微米尺寸时,将杂质分布垂直方向也缩写是很重要的。
现代器件结构如轻掺杂漏极(LDD),需要在纵向和横向上精确控制杂质分布。
垂直于表面的离子速度决定注入分布的投影射程。
如果硅芯片相对于离子束倾斜了一个很大的角度,则等效离子能量将大为减少。
在倾斜角度离子注入时,需考虑硅芯片上掩蔽图案的阴影效应。
较小的倾斜角度导致一个小阴影区。
如高为0.5um的掩蔽层,离子束的入射角为7度,将导致一个61nm的阴影区。
可能是器件产生一个预想不到的串联电阻。
60keV砷入射到硅中,相对浓度分布为离子束倾斜角度的函数,内插图所示是倾斜角度离子注入的阴影区
11高能量与大电流注入
注入机能量可高达1.5-5MeV,且已用作多种新型用途。
主要利用其能将杂质掺入半导体内深达好几个微米的能力而不需要借助高温下长时间的扩散。
也可用于制作低电阻埋层。
例如,CMOS器件中距离表面深达1.5到3um的埋层。
大电流注入机(10-20mA)工作在25-30keV范围下,通常用于扩散技术中的预置处理。
因为其总量能够精确控制。
在预置后,掺杂剂可以用高温扩散步骤再分布,同时顺便将表面区的注入损伤修补。
另一用途就是MOS器件的阈值电压调整,精确控制的杂质量经栅极氧化层注入沟道区。
目前,已有能量范围介于150-200keV的大电流离子注入。
主要用途是制作高品质硅层,通过向硅层中注入氧来生成二氧化硅从而使该硅层与衬底绝缘。
这种氧注入隔离(SIMOX)是一种绝缘层上硅(SOI)的关键技术。
2.8离子注入主要参数:
离子注入的几何说明:
α:
离子束注入面
∑:
表面
β:
模拟的平面
θ:
离子束方向与y轴方向的夹角
φ:
离子束与模拟平面之间的夹角
参数说明:
Species:
注入的杂质种类
Energy:
注入能量(KeV)
Dose:
注入剂量,单位cm-2
Tilt:
离子束注入的纵向角度,默认值是7º
Rotation:
离子束与模拟平面之间的夹角,默认值是30º
12离子注入系统
离子源:
用于离化杂质的容器。
常用的杂质源气体有BF3、AsH3和PH3等。
质量分析器:
不同离子具有不同的电荷质量比,因而在分析器磁场中偏转的角度不同,由此可分离出所需的杂质离子,且离子束很纯。
加速器:
为高压静电场,用来对离子束加速。
该加速能量是决定离子注入深度的一个重要参量。
秘诀:
好市口+个性经营中性束偏移器:
利用偏移电极和偏移角度分离中性原子。
营销环境信息收集索引聚焦系统:
用来将加速后的离子聚集成直径为数毫米的离子束。
1、你一个月的零用钱大约是多少?
偏转扫描系统:
用来实现离子束x、y方向的一定面积内进行扫描。
工作室:
放置样品的地方,其位置可调。
附件
(一):
13离子注入主要解决的问题
1)纯度
2)
3)
(2)物品的独一无二深度
4)浓度
5)
6)民族性手工艺品。
在饰品店里,墙上挂满了各式各样的小饰品,有最普通的玉制项链、珍珠手链,也有特别一点如景泰蓝的手机挂坠、中国结的耳坠,甚至还有具有浓郁的异域风情的藏族饰品。
均匀性
7)稳定性
14离子注入优缺点
优点:
1)可在较低的温度下,将各种杂质掺入到不同的半导体中;
大学生对手工艺制作兴趣的调研2)能精确控制掺入基片内杂质的浓度分布和注入深度;
3)可以实现大面积均匀掺杂,而且重复性好;
4)掺入杂质纯度高;
手工艺制品是我国一种传统文化的象征,它品种多样,方式新颖,制作简单,深受广大学生朋友的喜欢。
当今大学生的消费行为表现在追求新颖,追求时尚。
追求个性,表现自我的消费趋向:
购买行为有较强的感情色彩,比起男生热衷于的网络游戏,极限运动,手工艺制品更得女生的喜欢。
5)获得主浓度扩散层不受故浓度限制
6)由于注入粒子的直射性,杂质的横向扩散小;
7)可以置备理想的杂质分布;
8)可以通过半导体表面上一定厚度的四SiO2膜进行注入而实行掺杂;
因此不难看出,自制饰品在校园里也大有市场所在。
对于那些走在流行前端的女生来说,〝捕捉〞新事物便〝捕捉〞到了时尚与个性。
9)工艺条件容易控制。
缺点:
二、资料网址:
1)高能离子注入改变晶格结构;
2)设备贵
- 配套讲稿:
如PPT文件的首页显示word图标,表示该PPT已包含配套word讲稿。双击word图标可打开word文档。
- 特殊限制:
部分文档作品中含有的国旗、国徽等图片,仅作为作品整体效果示例展示,禁止商用。设计者仅对作品中独创性部分享有著作权。
- 关 键 词:
- 离子 注入 快速 退火 工艺 电子 教案
 冰豆网所有资源均是用户自行上传分享,仅供网友学习交流,未经上传用户书面授权,请勿作他用。
冰豆网所有资源均是用户自行上传分享,仅供网友学习交流,未经上传用户书面授权,请勿作他用。


 铝散热器项目年度预算报告.docx
铝散热器项目年度预算报告.docx
