 电力电子半导体器件(IGBT).pptx
电力电子半导体器件(IGBT).pptx
- 文档编号:175643
- 上传时间:2022-10-05
- 格式:PPTX
- 页数:47
- 大小:3.85MB
电力电子半导体器件(IGBT).pptx
《电力电子半导体器件(IGBT).pptx》由会员分享,可在线阅读,更多相关《电力电子半导体器件(IGBT).pptx(47页珍藏版)》请在冰豆网上搜索。
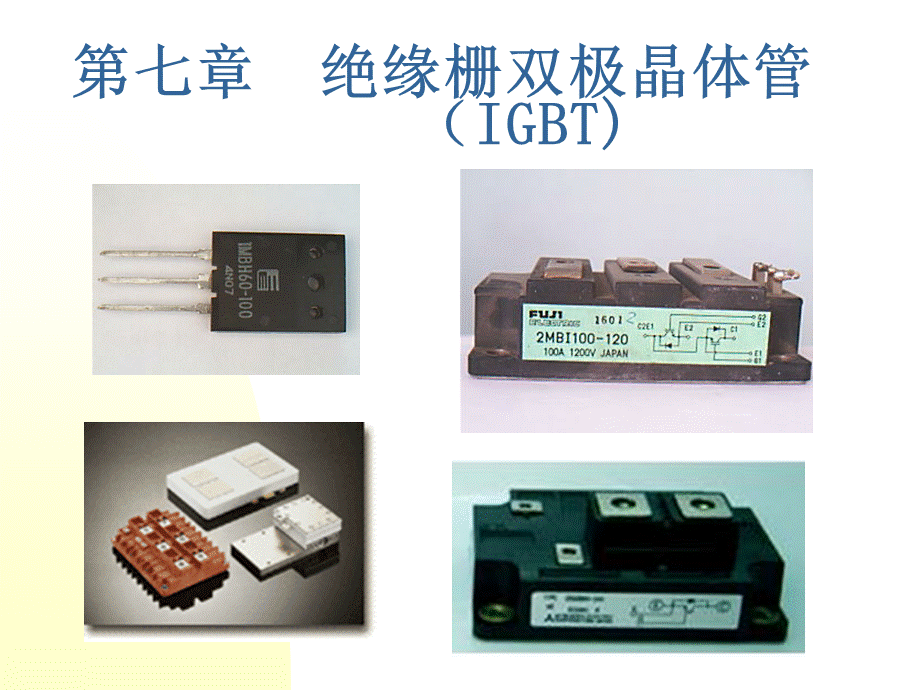
第七章绝缘栅双极晶体管(IGBT),7.1原理与特性,一、概述IGBTInsulatedGateBipolarTransistor近年来出现了许多新型复合器件,它们将前述单极型和双极性器件的各自优点集于一身,扬长避短,使其特性更加优越,具有输入阻抗高、工作速度快、通态电压低、阻断电压高、承受电流大等优点,因而发展很快应用很广,已成为当前电力半导体器件发展的重要方向。
其中尤以绝缘栅双极晶体管(1GBT)最为突出,在各个领域中有取代前述全控型器件的趋势。
IGBT(IGT),1982年研制,第一代于1985年生产,主要特点是低损耗,导通压降为3V,下降时间0.5us,耐压500600V,电流25A。
第二代于1989年生产,有高速开关型和低通态压降型,容量为400A/5001400V,工作频率达20KHZ。
目前第三代正在发展,仍然分为两个方向,一是追求损耗更低和速度更高;另一方面是发展更大容量,采用平板压接工艺,容量达1000A,4500V;命名为IEGT(InjectionEnhancedGateTransistor)二、工作原理:
IGBT是在功率MOSFET的基础上发展起来的,两者结构十分类似,不同之处是IGBT多一个P+层发射极,可形成PN结J1,并由此引出漏极;门极和源极与MOSFET相类似。
1分类:
按缓冲区有无分为:
非对称型IGBT:
有缓冲区N+,穿通型IGBT;由于N+区存在,反向阻断能力弱,但正向压降低,关断时间短,关断时尾部电流小。
对称型IGBT:
无缓冲区N+,非穿通型IGBT;具有正、反向阻断能力,其他特性较非对称型IGBT差。
按沟道类型:
N沟道IGBTP沟道IGBT,2开通和关断原理:
IGBT的开通和关断是由门极电压来控制的。
门极施以正电压时,MOSFET内形成沟道,并为PNP晶体管提供基极电流,从而使IGBT导通。
在门极上施以负电压时,MOSFET内的沟道消失,PNP晶体管的基极电流被切断,IGBT即为关断。
VDS为负时:
J3结处于反偏状态,器件呈反向阻断状态。
VDS为正时:
VGVT,绝缘门极下形成N沟道,由于载流子的相互作用,在N-区产生电导调制,使器件正向导通。
关断时拖尾时间:
在器件导通之后,若将门极电压突然减至零,则沟道消失,通过沟道的电子电流为零,使漏极电流有所突降,但由于N-区中注入了大量的电子、空穴对,因而漏极电流不会马上为零,而出现一个拖尾时间。
锁定现象:
由于IGBT结构中寄生着PNPN四层结构,存在着由于再生作用而将导通状态锁定起来的可能性,从而导致漏极电流失控,进而引起器件产生破坏性失效。
出现锁定现象的条件就是晶闸管的触发导通条件:
1+2=1a.静态锁定:
IGBT在稳态电流导通时出现的锁定,此时漏极电压低,锁定发生在稳态电流密度超过某一数值时。
b.动态锁定:
动态锁定发生在开关过程中,在大电流、高电压的情况下、主要是因为在电流较大时引起1和2的增加,以及由过大的dv/dt引起的位移电流造成的。
c.栅分布锁定:
是由于绝缘栅的电容效应,造成在开关过程中个别先开通或后关断的IGBT之中的电流密度过大而形成局部锁定。
采取各种工艺措施,可以提高锁定电流,克服由于锁定产生的失效。
三、基本特性:
(一)静态特性1伏安特性:
几十伏,无反向阻断能力,饱和区,放大区,击穿区,2饱和电压特性:
IGBT的电流密度较大,通态电压的温度系数在小电流范围内为负。
大电流范围为正,其值大约为1.4倍100。
3转移特性:
与功率MOSFET的转移特性相同。
当门源电压VGS小于开启电压VT时,IGBT处于关断状态,加在门源间的最高电压由流过漏极的最大电流所限定。
一般门源电压最佳值15V。
4开关特性:
与功率MOSFET相比,IGBT通态压降要小得多,1000V的IGBT约有25的通态压降。
这是因为IGBT中N漂移区存在电导调制效应的缘故。
(二)动态特性1开通过程:
td(on):
开通延迟时间tri:
电流上升时间tfv1,tfv2:
漏源电压下降时间tfv1:
MOSFET单独工作时的电压下降时间。
tfv2:
MOSFET和PNP管同时工作时的电压下降时间。
随漏源电压下降而延长;受PNP管饱和过程影响。
平台:
由于门源间流过驱动电流,门源间呈二极管正向特性,VGS维持不变。
2关断过程:
td(off):
延迟时间trv:
VDS上升时间tfi2:
由PNP晶体管中存储电荷决定,此时MOSFET已关断,IGBT又无反向电压,体内存储电荷很难迅速消除,因此下降时间较长,VDS较大,功耗较大。
一般无缓冲区的,下降时间短。
由MOSFET决定,3开关时间:
用电流的动态波形确定开关时间。
漏极电流的开通时间和上升时间:
开通时间:
ton=td(on)+tri上升时间:
tr=tfv1+tfv2漏极电流的关断时间和下降时间:
关断时间:
toff=td(off)+trv下降时间:
tf=tfi1+tfi2反向恢复时间:
trr,4开关时间与漏极电流、门极电阻、结温等参数的关系:
5开关损耗与温度和漏极电流关系,(三)擎住效应IGBT的锁定现象又称擎住效应。
IGBT复合器件内有一个寄生晶闸管存在,它由PNP利NPN两个晶体管组成。
在NPN晶体管的基极与发射极之间并有一个体区电阻Rbr,在该电阻上,P型体区的横向空穴流会产生一定压降。
对J3结来说相当于加一个正偏置电压。
在规定的漏极电流范围内,这个正偏压不大,NPN晶体管不起作用。
当漏极电流人到定程度时,这个正偏量电压足以使NPN晶体管导通,进而使寄生晶闸管开通、门极失去控制作用、这就是所谓的擎住效应。
IGBT发生擎住效应后。
漏极电流增大造成过高的功耗,最后导致器件损坏。
漏极通态电流的连续值超过临界值IDM时产生的擎住效应称为静态擎住现象。
IGBT在关断的过程中会产生动态的擎住效应。
动态擎住所允许的漏极电流比静态擎住时还要小,因此,制造厂家所规定的IDM值是按动态擎住所允许的最大漏极电流而确定的。
动态过程中擎住现象的产生主要由重加dv/dt来决定,此外还受漏极电流IDM以及结温Tj等因素的影响。
在使用中为了避免IGBT发生擎住现象:
1设计电路时应保证IGBT中的电流不超过IDM值;2用加大门极电阻RG的办法延长IGBT的关断时间,减小重加dVDS/dt。
3器件制造厂家也在IGBT的工艺与结构上想方设法尽可能提高IDM值,尽量避免产生擎住效应。
(四)安全工作区1FBSOA:
IGBT开通时正向偏置安全工作区。
随导通时间的增加,损耗增大,发热严重,安全区逐步减小。
2RBSOA:
IGBT关断时反向偏置安全工作区。
随IGBT关断时的重加dVDS/dt改变,电压上升率dVDS/dt越大,安全工作区越小。
通过选择门极电压、门极驱动电阻和吸收回路设计可控制重加dVDS/dt,扩大RBSOA。
最大漏极电流,最大漏源电压VDSM,(五)具体参数和特性,7.2门极驱动,一、驱动条件:
门极驱动电路的正偏压VGS,负偏压VGS,门极电阻RG的大小,决定IGBT的静态和动态特性,如:
通态电压、开关时间、开关损耗、短路能力、电流di/dt及dv/dt。
1正偏电压VGS的影响,VGS增加时,通态压降下降,开通时间缩短,开通损耗减小,但VGS增加到一定程度后,对IGBT的短路能力及电流di/dt不利,一般VGS不超过15V。
(12V15V),2负偏压VGS的影响:
门极负偏压可以减小漏极浪涌电流,避免发生锁定效应,但对关断特性影响不大。
如图:
3门极电阻RG的影响:
当门极电阻RG增加时,IGBT的开通与关断时间增加,进而使每脉冲的开通能耗和关断能损也增加。
但RG减小时,IGBT的电流上升率di/dt增大,会引起IGBT的误导通,同时RG电阻的损耗也增加。
一般,在开关损耗不太大的情况下,选较大的电阻RG。
4IGBT驱动电路设计要求:
(1)由于是容性输入阻抗,因此IGBT对门极电荷集聚很敏感,驱动电路必须很可靠,要保证有一条低阻抗值的放电回路。
(2)用低内阻的驱动源对门极电容充放电以保证门极控制电压VGS有足够陡峭的前后沿,使IGBT的开关损耗尽量小。
另外IGBT开通后,门极驱动源应提供足够的功率使IGBT不致退出饱和而损坏。
(3)门极电路中的正偏压应为+12+15V;负偏压应为210V。
(4)IGBT多用于高压场合,故驱动电路应与整个控制电路在电位上严格隔离。
(5)门极驱动电路应尽可能简单实用,具有对IGBT的自保护功能,并有较强的抗于扰能力。
(6)若为大电感负载,IGBT的关断时间不宜过短,以限制di/dt所形成的尖峰电压,保证IGBT的安全。
二、驱动电路:
在满足上述驱动条件下来设计门极驱动电路,IGBT的输入特性与MOSFET几乎相同,因此与MOSFET的驱动电路几乎一样。
注意:
1IGBT驱动电路采用正负电压双电源工作方式。
2信号电路和驱动电路隔离时,采用抗噪声能力强,信号传输时间短的快速光耦。
3门极和发射极引线尽量短,采用双绞线。
4为抑制输入信号振荡,在门源间并联阻尼网络。
三、常用PWM控制芯片:
TL494,SG3524,SG1525,MC3520,MC34060,VC1840,SL-64等。
四、IGBT专用驱动模块:
大多数IGBT生产厂家为了解决IGBT的可靠性问题,都生产与其相配套的混合集成驱动电路,如日本富士的EXB系列、日本东芝的TK系列,美国库托罗拉的MPD系列等。
这些专用驱动电路抗干扰能力强,集成化程度高,速度快,保护功能完善,可实现IGBT的最优驱动。
富士的EXB841快速驱动电路,由放大电路,过流保护电路,5V基准电压源电路组成。
具有过流缓关断功能。
7.3IGBT的保护,一、常用的保护措施:
(1)通过检出的过电流信号切断门极控制信号,实现过电流保护
(2)利用缓冲电路抑制过电压并限制过量的dv/dt。
(3)利用温度传感器检测IGBT的壳温,当超过允许温度时主电路跳问,实现过热保护。
二、过电流保护措施及注意问题:
1IGBT短路时间:
2过电流的识别:
采用漏极电压的识别方法,通过导通压降判断漏极电流大小。
进而切断门极控制信号。
注意:
识别时间和动作时间应小于IGBT允许的短路过电流时间(几个us),同时判断短路的真与假,常用方法是利用降低门极电压使IGBT承受短路能力增加,保护电路动作时间延长来处理。
3保护时缓关断:
由于IGBT过电流时电流幅值很大,加之IGBT关断速度快。
如果按正常时的关断速度,就会造成Ldi/dt过大形成很高的尖峰电压,造成IGBT的锁定或二次击穿,极易损坏IGBT和设备中的其他元器件,因此有必要让IGBT在允许的短路时间内采取措施使IGBT进行“慢速关断”。
采用电流互感器和霍尔元件进行过流检测及过流保护:
三、缓冲电路利用缓冲电路抑制过电压,减小dv/dt。
50A,200A,200A,缓冲电路参数估算:
缓冲电容:
L主回路杂散电感(与配线长度有关)I0关断时漏极电流VCEP缓冲电容上电压稳态值(有安全区确定)Ed直流电源电压缓冲电阻:
在关断信号到来前,将缓冲电容上电荷放净,f:
开关频率,缓冲电阻功率:
LS:
缓冲电路电感,7.4应用实例,一、静音式变频调速系统,二、工业加热电源:
三、逆变弧焊电源:
四、不间断电源:
UPS,五、有源功率滤波器:
第八章新型电力半导体器件,一、新型电力电子器件IGCT集成门极换流晶闸管IGCT(IntegratedGateCommutatedThyristor)是1996年问世的一种新型半导体开关器件。
该器件是将门极驱动电路与门极换流晶闸管GCT集成于一个整体形成的。
门极换流晶闸管GCT是基于GTO结构的一种新型电力半导体器件,它不仅有与GTO相同的高阻断能力和低通态压降,而且有与IGBT相同的开关性能,即它是GTO和IGBT相互取长补短的结果,是一种较理想的兆瓦级、中压开关器件,非常适合用于6kV和10kV的中压开关电路。
IGCT芯片在不串不并的情况下,二电平逆变器容量0.5M3MVA,三电平逆变器1M6MVA。
若反向二极管分离,不与IGCT集成在一起,二电平逆变器
- 配套讲稿:
如PPT文件的首页显示word图标,表示该PPT已包含配套word讲稿。双击word图标可打开word文档。
- 特殊限制:
部分文档作品中含有的国旗、国徽等图片,仅作为作品整体效果示例展示,禁止商用。设计者仅对作品中独创性部分享有著作权。
- 关 键 词:
- 电力 电子 半导体器件 IGBT
 冰豆网所有资源均是用户自行上传分享,仅供网友学习交流,未经上传用户书面授权,请勿作他用。
冰豆网所有资源均是用户自行上传分享,仅供网友学习交流,未经上传用户书面授权,请勿作他用。


 党组织、党员联系服务师生工作制度.docx
党组织、党员联系服务师生工作制度.docx
 物流与供应链管理 第七章 供应链综合计划.pptx
物流与供应链管理 第七章 供应链综合计划.pptx
 回弹仪检测多孔砖砖强度计算表.xls
回弹仪检测多孔砖砖强度计算表.xls
