 半导体工艺课件PPT格式课件下载.ppt
半导体工艺课件PPT格式课件下载.ppt
- 文档编号:15554120
- 上传时间:2022-11-04
- 格式:PPT
- 页数:324
- 大小:15.31MB
半导体工艺课件PPT格式课件下载.ppt
《半导体工艺课件PPT格式课件下载.ppt》由会员分享,可在线阅读,更多相关《半导体工艺课件PPT格式课件下载.ppt(324页珍藏版)》请在冰豆网上搜索。
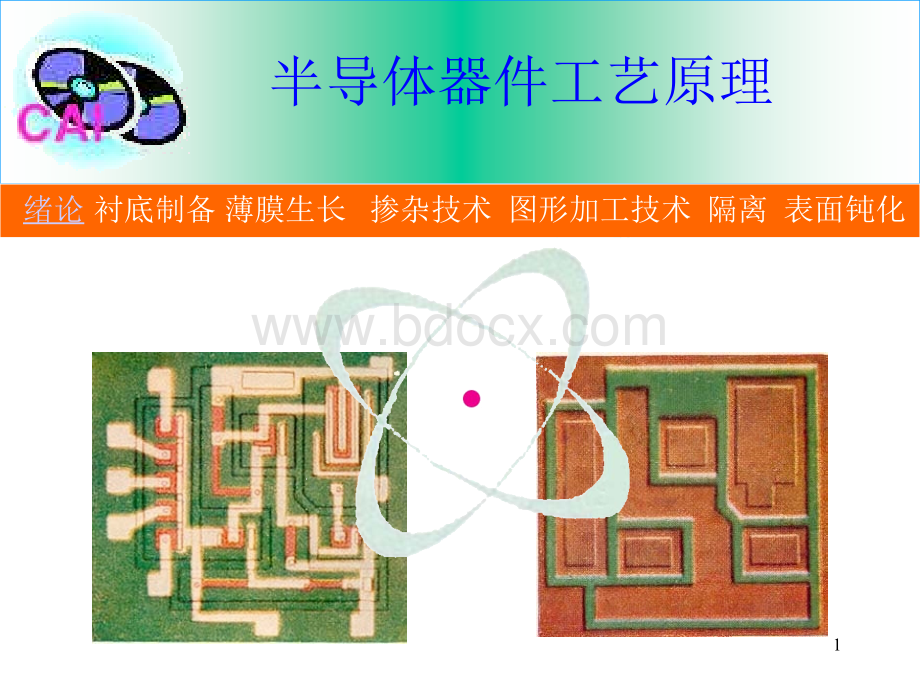
80150nm。
光刻1:
刻场区(3)等离子腐蚀Si3N4和场区注硼。
E=100150Kev;
D=6101261013cm-2(4)场氧化:
水汽氧化:
9001050,t=615h。
d=11.7m。
11(5)腐蚀氧化层;
等离子去除氮化硅;
腐蚀氧化层;
栅区氧化:
HCl氧化9001000;
d=4070nm;
光刻耗尽区;
耗尽区砷注入:
E=150700Kev;
D=5101121012cm-2.(6)去胶;
光刻增强区;
增强区注入:
E=3050Kev;
D=1101141011cm-2。
(7)去胶;
光刻硅和多晶硅接触孔;
Qf调整:
在干N2中9001000退火、t=30min(8)多晶硅生长:
LPCVD法d=400600nm;
光刻栅:
等离子腐蚀多晶硅。
12(9)腐蚀源漏区的栅氧化层;
磷预淀积;
用10/1的HF溶液漂PSG;
再扩散和氧化;
测s及结深(10)LPCVD法淀积PSG:
d=400800nm、掺磷79%;
回熔:
9001000;
光刻接触孔。
(11)溅射铂,形成铂-硅,去除铂。
溅射钛-钨,淀积铝,光刻5及腐蚀金属层(12)合金化,中测,淀积氧化层,光刻6及腐蚀压焊点。
硅片减薄,蒸金及金的合金化13氧化物硅栅CMOS工艺流程14原始材料3或4英寸N型硅片,晶向为100,电阻率在24一次氧化温度9001050,0.080.15mSiO2,测量氧化层厚度。
淀积氮化硅用LPCVD法,厚度为0.080.15m光刻1参阅图1-3a刻场区。
本工序须在黄色光照明区进行1a匀光刻胶;
1b前烘;
1c使版与硅片参考面对准(或将版和以前形成的图形对准)并曝光;
1d显影;
1e目视检查(测量关键尺寸)返修废片;
1f坚膜(如果用等离子腐蚀,或是在离子注入前,不一定要坚膜);
1g等离子刻蚀氮化硅(这步刻蚀后不去胶,因为要用胶作为场注入的阻挡层);
1h最后检查(检查关键尺寸)将报废片子除去氮化硅及氧化层并进行返修。
场注入(参阅图1-3b)在100150Kev条件下注磷:
剂量:
6101261013离子/cm2(根据电路的工作电压范围来确定注入剂量)15去胶除去阻挡注入的光刻胶场氧化(参阅图1-3c)温度9501050水气氧化615h。
氧化层厚1.01.7m。
去除氮化硅去掉氮化硅上的SiO2;
用等离子腐蚀机除去氮化硅。
光刻2P阱光刻。
采用1a1e工艺流程。
P阱注入(参阅图1-3d)在4080Kev条件下注入硼;
1101321013离子/cm2(具体的注入剂量根据所要求的VT范围和以后的工序情况确定)。
去胶除去阻挡注入的光刻胶。
P阱扩散(参阅图1-3e)温度11501200,1224h16栅氧化除去有源区上的二氧化硅;
生长栅氧化层:
6090nm干氧,温度9001000;
测栅氧化层厚度;
测氧化层击穿电压淀积多晶硅厚度0.40.6m,用LPCVD方法。
多晶硅掺杂在9001000温度下扩磷,测量薄层电阻(3040/)光刻3(参阅图1-3f)光刻栅区,按光刻1a1e工艺流程进行,但用等离子刻蚀多晶硅,并在刻蚀后去胶。
然后检查硅片并检验关键尺寸。
光刻4光刻P沟源-漏区。
按光刻1a1e工艺流程进行。
P沟源-漏区注入(参阅图1-3g)在4060Kev条件下注入硼:
剂量410141015离子/cm2。
17光刻5光刻N沟源-漏区。
N沟源-漏区注入(参阅图1-3h)在80150Kev条件下注入磷,或在150!
200Kev条件下注入砷:
剂量8101441015离子/cm2。
CVD淀积SiO2厚度0.40.8m,含磷量911%(重量比)。
回流温度9001000,回流磷硅玻璃并激活注入离子。
光刻6(参阅图1-3i)光刻接触孔。
按光刻1工艺流程进行,但腐蚀二氧化硅前须坚膜。
腐蚀后去胶并检查硅片,检验关键尺寸。
金属化前清洗酸洗并在稀HF中短时间浸一浸。
淀积铝溅射或电子束蒸发淀积(0.60.8m)。
18光刻7(参阅图1-3j)光刻金属连线图形。
按光刻1工艺流程进行,但在腐蚀铝前须坚膜。
合金/退火温度400500,在含30%H2(或超过30%)的氮气中进行。
电气测量测量晶体管的VT、击穿电压、电阻值等器件参数。
超出规定值范围的硅片应拒收(返修或报废)。
淀积防擦伤保护层厚度0.1m不掺杂CVD二氧化硅;
厚度0.4m,24%含磷量(重量比)的CVD二氧化硅;
厚度0.1m不掺杂CVD二氧化硅。
光刻8(参阅图1-3k)刻压焊点。
用等离子腐蚀。
背面处理/硅片减薄对硅片背面进行磨削或研磨以除去背面形成的二极管;
并且由于功率耗散的原因将硅片减薄至所要求的厚度。
蒸金为了以后芯片烧结的需要,在背面蒸发或溅射(0.20.4m)金。
19金的合金(参阅图1-3l)温度380420,N2中进行。
中测将不合格芯片打上标记。
装配将合格芯片封装作进一步测试。
20目录第一章第二章第三章第四章第五章第六章1-1衬底材料1.对衬底材料的要求2.衬底单晶材料的制备3.杂质缺陷对器件工艺质量的影响4.多晶硅的结构性质1-2衬底制备1.晶体定向2.晶片加工参观实验室21第第一一章章221、对衬底材料的要求:
a.导电类型P或Nb.电阻率:
0.001100000c.寿命一般要求几到几千微秒d.晶格完整性e.纯度高一般常说的9个9f.晶向111及110等g.要求一定的直径和均匀性,并给出主次定位面一、衬底材料一、衬底材料232、衬底单晶材料的制备悬浮区熔法生长过程示意图单晶生长水平区熔法示意图硅单晶直拉法生产过程示意图24二、衬底制备硅衬底制备工艺流程单晶锭滚磨整形确定定位面磨定位面晶体定向化学腐蚀切片磨片倒角清洗检验抛光减薄返回目录25目录第一章第二章第三章第四章第五章第六章2-1硅外延薄膜制备的原理1.外延生长动力学原理2.外延掺杂及其杂质再分布3.自掺杂效应2-2二氧化硅薄膜1.结构与性质2.热生长氧化膜的制备3.实现掩蔽扩散的条件参观实验室2-3热分解淀积氧化膜法1.烷氧基硅烷热分解淀积法2.硅烷热氧化淀积法3.淀积法形成二氧化硅膜的特点26薄膜制备制备薄膜所需要的原子或分子是由含其组元的化合物通过氧化、还原或热分解等化学反应而得到。
它不经过中间化学反应,以源直接转移到衬底上形成薄膜。
在半导体器件中广泛使用着各种薄膜,制备薄膜的方法有:
直接生长法:
间接生长法:
第二章第二章27一、硅外延薄膜制备的原理外延:
一定条件下,在一片表面经过细致加工的单晶衬底上,沿其原来的结晶轴方向,生长一层导电类型、电阻率、厚度和晶格结构完整性都符合要求的新单晶层的过程。
同质外延:
异质外延:
外延层在结构、性质上与衬底材料不同。
生长的外延层与衬底材料相同。
281、外延生长动力学原理外延时,通入含有一定硅源的氢气流,并流经被高频感应加热的硅片表面,当条件适当时便会在其上外延成膜.29硅外延反应器30SiCl4(气)气)+2H2(气)气)=Si(固)固)+4HCl(气)气)HH22还原还原SiClSiCl44法的化学反应式为:
法的化学反应式为:
滞流层(附面层):
接近基座表面的一薄层流体的速度有较大变化,滞慢于其外面的自由流体,把这个区域叫做滞流层。
31混合气体流经基座时的情况(a)滞流层(b)微流体元及速度分布附面层附面层32滞留层里气体流速分布可表示为:
U=U0Y0Y(2-4)流体流动时,在单位面积上产生的内应力与速度在垂直方向上的变化率成正比,即(2-5)称为粘滞系数。
在滞流层内距原点x处取一垂直于基座表面的微流体元ABCD,它在垂直于纸面方向上有一个单位长度。
忽略压力沿x方向的损失,则该微流体元沿x方向只受到粘性内摩擦力的作用。
BC面的内摩擦力为零,而AD面的内摩擦力为33(2-6)式中负号表示内摩擦力沿着x轴负方向。
根据牛顿第二定律,该作用力引起微流体元内动量的变化。
由于流体的流动是连续的,从ABC面流进来的流体必然全部要从CD面流出。
作为近似,动量的变化可以看作是流体由BC面流入的结果。
而单位时间内从BC面流入的流体带入的动量为质量速度(2-7)该动量全部用在克服内摩擦力上,故有将式(2-6)和(2-7)带入上式,得到等式两边积分,并取34(2-8)这就是滞流层厚度的近似表达式,由此可求出平均滞流层厚为(2-9)式中称为平板雷诺数,是一个无量纲数,用它可以判断流体的运动状态仿照速度附面层,引入质量附面层的概念。
在质量附面层内浓度有较大的变化,其厚度可以表示为N设气体内部和生长表面的反应剂浓度分别为假定在质量附面层里反应剂浓度也呈线性分布即(2-10)35根据扩散理论,输运到外延层表面的反应剂粒子流密度为(2-11)式中为反应剂在氢气中的扩散系数,结合(2-10)式,得(2-12)式中称为气相质量转移系数,它具有速度的量纲另一方面,在生长层界面上进行化学反应所消耗的粒子流密度为(2-13)是表面化学反应速率常数。
在稳定状态下,(2-14)根据可分别得到在气体生长层界面上的反应剂浓度和外延生长速率为:
36由于气体的浓度常用摩尔分数表示,所以上式改为(2-15)(2-16)(2-17)为混合气体中每立方厘米的分子总数;
为反应剂的摩尔分数因为是混合气体总压强在开管外延中,在数值上也等于以大气压为单位的反应剂分压强37表面反应控制:
生长速率讨论生长速率讨论38质量转移控制:
39影响外延生长速率的因素:
生长速率和反应剂浓度的关系成正比40生长速率与外延温度的关系:
较高温度下,速率与温度的关系不明显。
较低温度下,速率随绝对温度的增加呈指数急增。
41生长速率与气体流量的关系:
流量较小时,生长速率与流量的平方根成正比42与硅片位置等的关系:
生长速率和x的平方根成反比,解决办法:
基座有一个小角度。
432、外延掺杂及其杂质再分布(11)掺杂原理)掺杂原理:
外延层中的杂质原子是在外延生长外延层中的杂
- 配套讲稿:
如PPT文件的首页显示word图标,表示该PPT已包含配套word讲稿。双击word图标可打开word文档。
- 特殊限制:
部分文档作品中含有的国旗、国徽等图片,仅作为作品整体效果示例展示,禁止商用。设计者仅对作品中独创性部分享有著作权。
- 关 键 词:
- 半导体 工艺 课件
 冰豆网所有资源均是用户自行上传分享,仅供网友学习交流,未经上传用户书面授权,请勿作他用。
冰豆网所有资源均是用户自行上传分享,仅供网友学习交流,未经上传用户书面授权,请勿作他用。


 12处方点评管理规范实施细则_精品文档.doc
12处方点评管理规范实施细则_精品文档.doc
 17种抗癌药纳入国家基本医疗保险工伤保险和生育保险药品目录_精品文档.xls
17种抗癌药纳入国家基本医疗保险工伤保险和生育保险药品目录_精品文档.xls
 医联体中信息化的建设方案.pptx
医联体中信息化的建设方案.pptx
